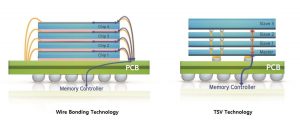
Компания Siemens Digital Industries Software объявила сегодня, что в результате ее сотрудничества с Advanced Semiconductor Engineering, Inc. (ASE) были созданы два новых вспомогательных решения, призванных помочь клиентам создавать и оценивать множество сложных сборок ИС и сценариев межсоединений.
Решения для реализации усовершенствованной упаковки с высокой плотностью (HDAP) являются результатом участия ASE в Siemens OSAT Alliance — программе, разработанной для ускорения внедрения новых технологий HDAP, таких как 2.5D, 3D IC и упаковка на уровне полупроводниковых пластин (FOWLP) для ИС нового поколения.
ASE имеет комплект для проектирования сборки (ADK), который помогает клиентам, использующим технологии ASE Fan Out Chip on Substrate (FOCoS) и 2.5D Middle End of Line (MEOL), в полной мере использовать поток проектирования Siemens HDAP.
ASE и Siemens договорились расширить свое партнерство, включив в него создание в будущем единой платформы проектирования от FOWLP до проектирования подложек 2.5D. Все эти совместные инициативы используют программное обеспечение Siemens XpeditionTM Substrate Integrator и платформу Caliber 3DSTACK.
«Приняв технологии Siemens Xpedition Substrate Integrator и Caliber 3DSTACK, а также за счет интеграции с текущим процессом проектирования ASE, мы теперь можем использовать этот совместно разработанный поток для значительного сокращения времени цикла планирования и проверки сборки пакетов 2.5D / 3D IC и FOCoS примерно на От 30 до 50 процентов в каждой итерации дизайна », — сказал д-р С. П. Хунг, вице-президент ASE Group. «Благодаря комплексному процессу проектирования мы теперь можем более быстро и легко совместно с нашими клиентами проектировать 2.5D / 3D IC и FOCoS и решать любые проблемы физической проверки для всей сборки их пластинчатых пакетов».
 Личный кабинет
Личный кабинет

 Загрузка
Загрузка